Company
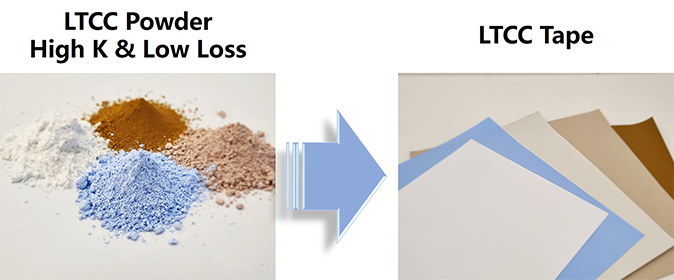
-
Powder(材料)
-
LTCC专用Powder(RNE-40)为Glass Free且介电损耗值低,
因此,可应用于High-Q Capacitor、Bluetooth & W-LAN Filter及Duplexer等各类部件。根据各种原材料和添加剂组合物的使用和经验,LTCC专用Tape可制成30 ~ 250 µm
的各种厚度,随时应用于各类部件。
6G通信组件
- 6G候选频段
-
为了满足5G/6G通信材料的要求,需要确保低介电-低损耗特性。为此,我们确保拥有在高频段具有稳定特性的陶瓷材料和内化合成技术,通过表面改性工程成功开发出最佳材料。
为了提高介电性能,我们正在研制具有耐热性和耐久性的Polymer和复合材料,开发可用于各种行业的材料。此外,我们还在开发可提升高速/集成模块散热特性的材料。
- Action item
-
- mm-Wave通信频段低介电-低损耗陶瓷成分设计及合成
- 介电陶瓷纳米粒子表面活化技术
- 有机-无机杂化低介电-低损耗材料合成



1st Treatment


2nd Treatment


Ceramic-Polymer Mixture

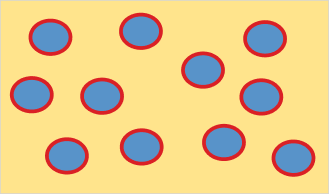
Ceramic-Polymer
Composite Sheet
Composite Sheet
材料和工艺

- 低损耗
-
- 采用导电性优良的银电极。
- 采用自主研发的陶瓷材料,
介电损耗低。

- 机械可靠性
-
- 热膨胀系数与半导体
传感器相似。 - 机械可靠性优于传感
器封装PCB。
- 热膨胀系数与半导体

- RN2专业技术
-
- 确保原材料、设计、
加工等整个工艺拥有
自主技术。 - 可根据项目选择经过
优化的材料和工艺。
- 确保原材料、设计、

- 3D多层电路
-
- Build-up Via工艺操作简单。
- 可制作10 Layer以上
的多层电路。
Road Map
- PRESENT (5G)
- NEXT-GENERATION (5G-A)
- FUTHER EVOLUTION
Coverage Area
| 2024 | 2025 | 2026 | 2027 | 2030 | ||
|---|---|---|---|---|---|---|
| Low band | <1GHz | &Service | ||||
| Lower-Mid Band | 1~7GHz | Sample | Service | Service | ||
| Upper-Mid Band | 7~24GHz | Sample | ||||
| High Band | >24GHz | TBD | ||||
Material
| LTCC | Composite | LTCC | Composite | Composite | ||
|---|---|---|---|---|---|---|
| 介电常数 | - | 7.8 | <4 | 6.9 | <3.5 | <3 |
| 介电损耗 | - | <0.0015 | <0.005 | <0.001 | <0.003 | ≒0.001 |
| Tg | ℃ | >600 | >100 | >600 | >120 | >120 |
| Td | ℃ | - | >300 | - | >400 | >400 |
| CTE | ppm/℃ | 5.8 | 15~20 | 5.3 | 10~15 | 10~15 |
| 导热系数 | W/(m⋅K) | 3.3 | 0.5 | 4.6 | 2~3 | 2~3 |
| 吸湿率 | % | - | 0.2~0.4 | - | <0.2 | <0.2 |
| 弯曲强度 | Mpa | 320 | - | 230 | - | - |
| 剥离强度 | kgf/cm | - | >1 | - | >1 | >1 |
Circuit
| 图案 Line/space | ㎛ | 100/100 | 100/100 | 100/100 | 50/50 | 50/50 |
|---|---|---|---|---|---|---|
| 电阻率 | uΩ·㎝ | <3 | <20 | <3 | <5 | <5 |
| 附着力 | - | - | 5B | 5B | 5B | 5B |
Foundry Service
- Foundry Service
-
Foundry Service是我们根据客户提供的产品Design,采用LTCC陶瓷工艺制作和供应产品的业务。我们采用独创的LTCC陶瓷材料和材料制造技术以及20多年的LTCC工艺技术,为客户提供产品制造服务。
与塑料PCB相比,LTCC是一种强度更高、耐热性更好的PCB材料,在极端环境下有局限性的材料中具有强竞争力。
此外,基于我们多年积累的技术和全球业务经验,我们可有效缩短供货时间,确保具有价格竞争力和质量可靠性,提升客户进入市场时的竞争力。- 강점 (Strength)
-
- 建设从原材料到基板的整条生产线
- 100%全检,品质保证。
- 确保材料、电路和工艺的设计能力。
- 拥有多年积累的技术和全球业务经验。
- 快速响应(一般PO交货时间为6周)。
Wire Boarding Pad
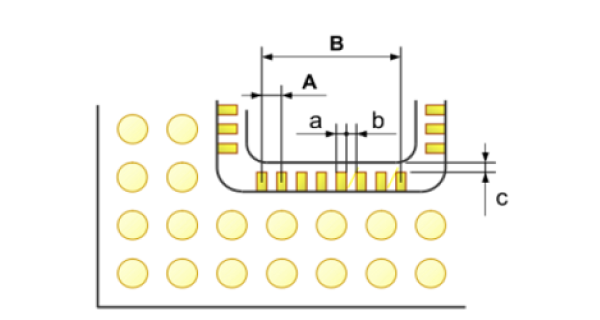
| Item | Standard | |
|---|---|---|
| a | Pad width | Min 200 um |
| b | Pad space | Min 100 um |
| c | Pad to Cavity | Min 200 um |
| A | Pad Pitch accuracy | ST ± 10% |
| B | Pad Pitch accuracy (Outer to Outer) |
ST ± 10% |
ST: Size Tolerance
Flip Chip Pad
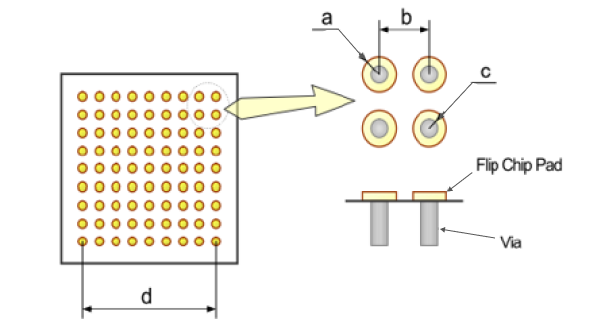
| Item | Standard | |
|---|---|---|
| a | Pad diameter | C + 100 um |
| b | Pad Pitch | a × 3 |
| c | Via diameter | Min 100 um |
| d | Distance between pad (Right end to Left end) |
ST ± 10% |
ST: Size Tolerance
Exposed signal & Buried signal conductor
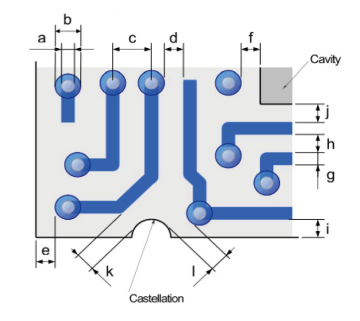
| Item | Standard | |
|---|---|---|
| a | Via diameter | Min 100 um |
| b | Via hole cover diameter | Via dia + 100 um |
| c | Via hole pitch | a × 4 |
| d | Via cover to line | Min 125 um |
| e | Via cover to substrate edge | Min 150 um |
| f | Via cover to cavity edge | Min 150 um |
| Item | Standard | |
|---|---|---|
| g | Line width | Min 100 um |
| h | Line spacing | Min 100 um |
| i | Line to substrate edge | Min 150 um |
| j | Line to cavity edge | Min 200 um |
| k | Castellation to line | Min 300 um |
| l | Castellation to line | Min 300 um |
ST: Size Tolerance
Ground Plane
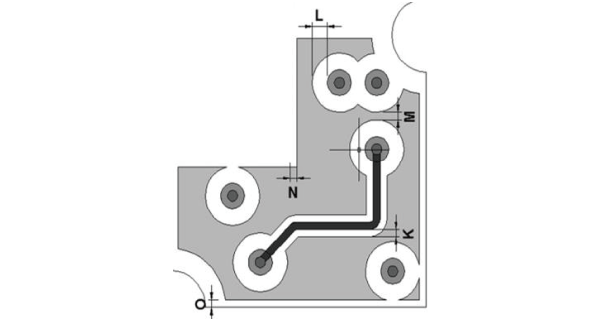
| Item | Standard | |
|---|---|---|
| K | Line to GND | Min 150 um |
| L | Isolation gap | Min 200 um |
| M | Solid plane | Min 200 um |
| N | Cavity edge to GND | Min 300 um |
| O | Substrate edge to GND | Min 300 um |
ST: Size Tolerance
Cavity Design
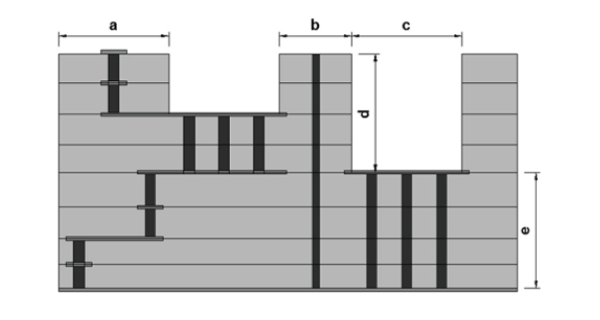
| Item | Standard | |
|---|---|---|
| a | Substrate edge to cavity edge | Min 2.0 mm |
| b | Cavity to cavity gap | Min 2.0 mm |
| c | Cavity width | Min 2.5 mm |
| d | Cavity height | Min 0.5 mm |
| e | Thickness under the cavity | Min 1.0 mm |
ST: Size Tolerance



